Файл:Illustration of C-V measurement.gif
Illustration_of_C-V_measurement.gif (322 × 308 пкс, размер файла: 93 КБ, MIME-тип: image/gif, закольцованный, 18 фреймов, 5,4 с)
История файла
Нажмите на дату/время, чтобы посмотреть файл, который был загружен в тот момент.
| Дата/время | Миниатюра | Размеры | Участник | Примечание | |
|---|---|---|---|---|---|
| текущий | 19:26, 17 мая 2010 | 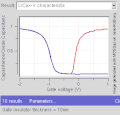 | 322 × 308 (93 КБ) | Beatnik8983 | {{Information |Description={{en|1=C-V measurements can reveal oxide thickness, oxide charges, contamination from mobile ions, and interface trap density in wafer processes. In this image the C-V profile for a bulk p-type substrate MOSCAP with different ox |
Использование файла
Следующая страница использует этот файл:
Глобальное использование файла
Данный файл используется в следующих вики:
- Использование в en.wikipedia.org
- Использование в fa.wikipedia.org
- Использование в hu.wikipedia.org
- Использование в ja.wikipedia.org
- Использование в zh.wikipedia.org
